| 其他相關文章: | ||||
 MFI與塑膠二次料/回收料的關係 (MFI & Re-grinding resin) |
 為何塑膠使用回收二次料強度會降低 |
 再談塑膠二次料的品質控管 |
 七個方法教你如何判度塑膠廠是否添加了二次料 (Re-grind resin) |
 貿易術語中買賣雙方各自應承擔的責任、風險和費用對照表 |
| 无觅 | ||||
錫鉛焊料的二元金相圖解釋
焊點微結構與強度關係試卷
| 其他相關文章: | ||||
 再論HSC(HeatSeal Connector)作業原理、修復與補強方法 |
 MLCC多層陶瓷電容破裂的可能原因 |
 你擔心【人員資遣】輪到你嗎? |
 連接器使用一段時間後掉落問題探討 |
 製造工廠的MRB會議及塑膠件品質判斷 |
| 无觅 | ||||
如何局部增加SMT製程中的錫膏或焊錫量
| 其他相關文章: | ||||
 如何局部增加SMT製程的焊錫量 |
 何謂SMT(Surface Mount Technology)? |
 介紹使用屏蔽夾來取代屏蔽框(SMT shielding can clip) |
 SMT連接器使用Nylon 6T與LCP塑料比較 |
 SMT PCBA組裝時應包含哪些設計文件? |
| 无觅 | ||||
SPI(Solder Paste Inspection)錫膏檢查機可以做什麼?
| 其他相關文章: | ||||
 如何挑選錫膏 (Solder paste selection) |
 如何將錫膏印刷於電路板(solder paste printing) |
 增加錫膏量可以改善BGA焊接不良? |
 初步認識【錫膏】 |
 把SMD零件改成通孔錫膏(Paste-In-Hole)製程有何差別及影響? |
| 无觅 | ||||
客戶評核SMT製程時最重要的程序及環節是什麼?
| 其他相關文章: | ||||
 SPI(Solder Paste Inspection)錫膏檢查機可以做什麼? |
 原來PCB的綠漆及絲印層厚度會影響錫膏量造成BGA短路? |
 如何局部增加SMT製程中的錫膏或焊錫量 |
 運用實驗設計法尋找SMT錫膏印刷厚度的管控條件 |
 初步認識【錫膏】 |
| 无觅 | ||||
焊接採用無鉛低溫錫膏SnBi, SnBiAg的目的?
| 其他相關文章: | ||||
 如何局部增加SMT製程中的錫膏或焊錫量 |
 運用實驗設計法尋找SMT錫膏印刷厚度的管控條件 |
 SPI(Solder Paste Inspection)錫膏檢查機可以做什麼? |
 密度(Density)解釋與ASTM-D1505及ISO-1183密度測定介紹 |
 [請教]DEK與MPM錫膏印刷機真的需要支撐真空塊嗎? |
| 无觅 | ||||
電路板焊接後為何要水洗?水洗製程、免洗製程有何差異?助焊劑的種類
關於預成型錫片(solder preforms)在SMT實際使用上的一些問題整理
錫膏中添加其他微量金屬的目的為何?
一圖說明SMT通孔回流焊(PIH)製程的印刷焊錫量如何計算
什麼是SMT葡萄球珠現象(Graping)?該如何解決?
在SMT的回焊(reflow)製程中出現葡萄球或葡萄珠現象(Graping),一般是指在回焊中錫膏沒有完全熔融 […]
The post 什麼是SMT葡萄球珠現象(Graping)?該如何解決? first appeared on 電子製造,工作狂人(ResearchMFG).
SPI管控的參數是怎麼訂出來的呢?錫膏厚度上下限如何定義?

(本文先不探討SPI設備本身量測的精準度問題,純粹只是就品質觀點來討論SPI的管控參數,這個議題沒有標準答案,歡迎留言討論提出你的看法)
工作熊發現有很多SMT工程師都不太清楚SPI的管控參數是如何定義出來的,尤其是針對錫膏厚度的中心值與上、下界限的公差是如何決定的更是莫栽央。
而大部分SMT工程師則會直接採用SPI廠商給的建議,有些比較有良心的廠商可能會建議以鋼板的厚度為中心值,然後下界限抓80%、上界限抓160%,有的甚至會直接建議【60%~200%】的公差值,這麼一來你可能會驚訝的發現怎麼SPI幾乎都不會報警且流程變得順暢無比,在這種條件下SPI大概只會抓出那些有嚴重堵塞或是拉尖特別嚴重的錫膏印刷缺失,這真的是你要的嗎?
你有想過設置SPI的真正目的是什麼?SPI可是我們花了大錢買來的,SPI真的就只能用來抓出這些重大缺失而已嗎?對於那些比較細小的零件(如0201以下零件)或是對錫膏量比較敏感的零件(如BGA)如果遵循同樣的公差標準真的不會出現焊錫問題嗎?
應該要以回焊後的焊錫品質來判斷錫膏量印刷是否恰當
想要釐清這個問題前,我們要來先來做幾個問答:
Q1:設置SPI的真正目的是什麼?
A1:應該是為了要提前檢查篩選出有否錫膏印刷不良的缺失。
Q2:那什麼叫做錫膏印刷不良?
A2:就是錫膏量印刷太多或太少。
Q3:那錫膏量印刷太多或太少會造成什麼問題?
A3:錫膏印多了會造成焊錫短路,錫膏印少了則會造成空焊。
所以最終我們應該要以回焊後的焊錫品質有否造成短路及空焊來評估該錫膏量是否恰當。
不同焊點對錫膏量精準度要求不一樣
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
這麼一來又會牽扯到另一個問題:「不同焊墊大小對錫膏量精準度的要求應該不一樣?」,比如說印刷在0201的錫膏量精準度要求應該會比0805的精準度來得高吧!也就是說越細小零件焊點的錫膏量公差應該要越小,這麼一來同一片板子上的不同焊點不就會有不同的公差需求?確實也是如此,真是傷腦筋。
不過,如果你想使用一個公差來管控同一片板子上的所有焊點也不是不可以,你只要選擇板子上對錫膏印刷量公差要求最嚴格的焊點來當成整片板子的公差來管控就可以了,而實際的作法應該也是如此,只要在碰到某個焊點一直報警時再檢查一下是否為比較大的焊點,是否可以放寬個別焊點公差來做調整就可以了,這樣也可以解決誤報率或漏放印刷不良的問題。
利用SPC與印刷機的製程能力來定義錫膏厚度的上、下界限
除了上述的試誤法之外,工作熊這裡會建議你採用SPC統計手法並依據錫膏印刷機的製程能力來定義錫膏厚度管控的上、下界限標準。
我們可以選定1~5個可以代表該片板子的焊點並透過SPC的手法來收集計算錫膏平均厚度的標準差(σ,sigma),這些焊點最好要包含板子上對錫膏量精準度要求較嚴格的FBGA (Fine-Pitch BGA)或是有細間距焊腳的零件,以及對錫膏量精準度要求比較鬆的大焊點。
規格中心值:
建議一樣取鋼板厚度來當做錫膏印刷的中心值。鋼板厚度是我們可以自己定義且管控的材料參數,而鋼板厚度其實也是我們在做錫膏印刷厚度所追求的目標值。
規格上、下界限:
一般應該要用+/-3σ來作為規格的上、下界限,然後逐步排除製程中的變異因素,但實際操作下來,會發現實際印刷出來的錫膏一般都會比鋼板的厚度要來得厚,原因是PCB上面會印有「防焊綠漆(solder mask)」與「絲印白漆(silkscreen)」會墊高鋼板,另外刮刀的壓力、速度與角度也會影響的錫膏量,還有一個很多人可能都忽略掉卻很嚴重的變異-板彎變形。所以…
-
如果實際錫膏厚度平均中心往上偏移約1.0σ時,建議上下界限可以取+/-4σ。這樣初始Cpk算出來會在1.0左右。
Cp=8σ/6σ, Ck=1σ/4σ, Cpk=(1-Ck)xCp=(1-1/4)x4/3=1.0 -
如果實際錫膏厚度中心往上偏移約1.5σ時,建議上下界限可以取+/-4.5σ。這樣初始Cpk算出來會在1.0左右。
Cp=9σ/6σ, Ck=1.5σ/4.5σ, Cpk=(1-Ck)xCp=(1-1/3)x3/2=1.0 -
不建議採用中心值偏移超過1.5σ以上的數據,而應該要先檢討為何錫膏印刷厚度會偏移中心值如此大,惕除不合理的數據之後再來使用SPC。
-
不建議移動規格中心值,因為我們的目標依然還是鋼板厚度,移動規格中心會讓我們的目標失準。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
當我們使用標準差(σ)定義出了錫膏厚度的規格上、下界限後,要再回去做確認與比對,當錫膏厚度剛好落在規格的上界限與下界限時,回焊後的焊錫品質必須仍然符合品質要求,然後要試著運用PDCA循環來提高Cpk。
下列有幾個方法提供給想改善錫膏印刷Cpk的朋友參考:
-
用魚骨圖列出所有可能影響錫膏印刷的因素,然後排除生產中所可能產生的「機遇變異」與「非機遇變異」。
-
調整錫膏印刷機中刮刀的設定參數(壓力、速度、角度)。
相關閱讀:
運用實驗設計法尋找SMT錫膏印刷厚度的管控條件
如何將錫膏印刷於電路板(solder paste printing)與影響錫膏印刷品質的因素 -
提昇鋼板品質。比如改用鐳射、奈米塗層、電鑄鋼板來穩定落錫量。
-
採用高號數的錫膏來增加落錫量。錫膏編號數越高,則錫粉的顆粒就越小,越容易下錫。
要想辦法讓錫膏厚度的中心值趨近鋼板厚度。當Cpk大於1.5後,建議要重新計算標準差(σ)縮小原來規格的上、下限,如此循環持續品質改善。
後記:
SPI除了可以管控錫膏印刷的厚度及錫量外,還可以管控印刷的偏移量,但是錫膏印刷的偏移量其實也受很多因素影響,除了鋼板及印刷機的精準度之外,最大的因素就是拼板及板材熱脹縮所造成的偏移量了,板材的品質可是一分錢一分貨的。
延伸閱讀:
簡介SMT表面貼焊流程中包含哪些製程與注意事項
SPI(Solder Paste Inspection)錫膏檢查機可以做什麼?
何謂SMT「紅膠」製程?什麼時候該用紅膠呢?有何限制呢?
整理SMT回焊爐添加氮氣(N2)對各種焊接不良的影響與效果

「氧化」是焊錫品質的一大殺手,但是氧化又是這個世界上所有元素趨吉避凶(趨向穩定狀態)的一種自然法則,無法避免,而「使用氮氣(N2)隔絕氧氣(O2)接觸」則是目前少數可以有效降低電子零件在高溫焊接時氧化的有效方法。
「氮氣(Nitrogen)」雖然不在8A鈍性氣體元素那一列中,不過在現代化學中,氮氣卻被歸類為「惰性氣體(inert gas)」的一種,它在自然界中非常不活潑,具有不易與金屬產生化合物的特性,而且在大氣中還有78%的佔比,取得的費用相對便宜,所以經常被用來充填在SMT焊接的回焊爐中置換氧氣(oxygen)的含量,少數波焊爐也會用氮氣填充,以減少焊錫或PCB焊墊於高溫時與空氣中的氧氣接觸而產生氧化反應。
將氮氣運用在回焊爐及波焊爐焊接雖然對焊接品質會有所提昇,好處也不少,但添加氮氣卻也不是百分百都是正向沒有缺點的。
下面工作熊收集整理氮氣對各種SMT焊接不良的影響與效果:
錫珠現象(Solder beads)
 「錫珠」也稱「焊珠」是相當常見的焊錫缺陷之一,它經常出現在零件本體的下方,尤其是在小電阻、小電容等small-chip本體下兩個端點的中間側面。
「錫珠」也稱「焊珠」是相當常見的焊錫缺陷之一,它經常出現在零件本體的下方,尤其是在小電阻、小電容等small-chip本體下兩個端點的中間側面。
這是因為高溫時錫膏內含的助焊劑會迅速轉變成氣體揮發並帶著部份的錫膏往外側移動(想像氣炸的情形),於是在零件本體與PCB間的小縫隙下就會形成分離的錫膏區塊,回焊時零件下方因為沒有焊墊可以吸引熔融的錫膏,再加上零件本體的重量擠壓,於是分離的熔融錫膏就從零件的本體下方冒出並在其邊緣上形成小錫珠。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
錫珠形成的另外一個主因則是【錫膏氧化】,由於現在電子零件大小差異巨大,在開鋼板的工藝中為了配合小零件採用較薄的鋼板,而針對大零件焊腳則採用外擴在增加錫膏量,一旦錫膏開封過久或是暴露於空氣中過久,就容易造成錫膏氧化及助焊劑部份揮發,當錫膏熔融時表面形成了較厚的氧化層,進而降低了錫膏的活性,使得熔融錫膏無法藉由內聚力將外擴的焊錫完全牽引回到本體,這些留存在焊墊外的焊錫就會形成獨立的錫珠。
在回焊爐中填充氮氣,無論是那一種錫膏,其錫珠出現的數量都會有所減少。這應該是因為低氧環境下有效降低了錫粉顆粒表面氧化膜的形成,讓錫粉間可以更好更快的融合在一起,降低了助焊劑噴濺時帶出的錫量。
另外,氮氣也可以有效的抑制PCB焊墊/焊盤在回焊高溫時氧化的程度,尤其針對第二面回流焊品質的提昇更佳,因為只要焊墊容易吃錫,就可以有效回收外擴的焊錫。
空洞/氣泡現象(Bubbles/Voids)
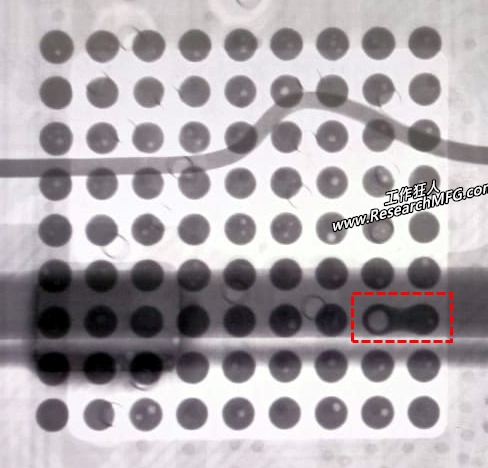
同「錫珠」類似的道理,在QFN中央位置的接地焊點容易出現空洞/氣泡現象,除了一些設計上留存導通孔(vias)造成氣泡或吃錫不足者,由於焊墊/焊盤表面在氮氣條件下可以有更好的潤濕,所以空洞率自然就減少。其次,氮氣讓錫粉間彼此可以更快速的潤濕也可以更有效地排出在回流焊熔融狀態下氣體無法逸出的問題。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
回焊爐中填充氮氣對於降低BGA錫球的氣泡也有同樣的效果。
但是,上述的結果並不一定完全適用於所有的焊點。曾經看過添加氮氣後反而增加BGA氣泡空洞率的例子。也許是我們對於BGA錫球氣泡形成的原因還不夠透徹吧!
葡萄球現象(Graping)
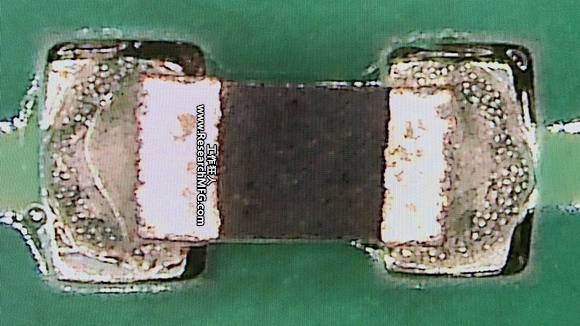
葡萄球或葡萄珠現象(Graping)一般是指在回焊中錫膏沒有完全互相融合焊接在一起,反而聚集變成一粒粒各自獨立的錫珠並堆疊在一起,形成類似葡萄球串的現象。
葡萄球現象的形成通常來自錫膏本身氧化或是錫膏中助焊劑提前揮發以致錫粉表面的氧化膜太厚而無法被突破或完全清除以達成互相熔融的事實。隨著電子零件越做越小,錫膏的印刷量也跟著越來越少,相對地錫膏中錫粉直接暴露在空氣中的表面積比率也就明顯增加,如果使用更小的錫粉直徑(更大的號數),錫粉表面積氧化比率也會更高。
想像10顆與100顆玻璃珠分別用膠水堆在一起成為方塊的樣子,100顆一堆的玻璃珠中被包覆在內層的比率是否比10顆玻璃珠來得多,而錫膏中的錫粉就像玻璃珠一樣,膠水則是助焊劑。堆疊的錫膏處於越最外層的錫粉則容易與空氣接觸而發生氧化,內層的錫粉則可以互相融合。這也是為何有些焊錫看起來有葡萄球現象卻未影響產品的功能。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
在回焊爐中添加氮氣可以降低錫粉在回焊爐中氧化的風險,但如果錫膏已經提前氧化、或是其助焊劑無法發揮保護錫粉清除氧化的作用,那麼添加氮氣對葡萄球現象是沒有幫助的。
相關延伸閱讀:什麼是SMT葡萄球珠現象(Graping)?該如何解決?
枕頭效應(Head-in-Pillow, Head-on-Pillow)

「枕頭效應(HIP/HoP)」的形成原因最主要是BGA零件在回焊(Reflow)的高溫過程中,BGA載板或是電路板因無法任受高溫而發生板彎、板翹(warpage)或是其他原因變形,使得BGA的錫球(ball)與印刷在電路板上的錫膏分離,當電路板經過高溫「回焊區(reflow zone)」後冷卻,BGA載板與電路板的變形也慢慢回復到之前的狀況,但這時的溫度早已低於熔錫溫度,於是便形成類似一顆頭靠在枕頭上的虛焊或假焊的焊接形狀。
另一種可能原因是BGA錫球已經發生些微的氧化,當錫膏的助焊劑活性不足以清除BGA錫球上的氧化層,就會阻擋錫膏與BGA錫球融合,最終造成兩個球靠在一起的現象。
在回焊爐添加氮氣則可以部份解決因為助焊劑活性不足問題,但對於因為電路板或BGA載板變形而造成的HoP/HIP則無濟於事。
相關延伸閱讀:BGA枕頭效應(head-in-pillow,HIP)發生的可能原因與機理
潤濕不良(Non-wetting)

回焊爐中添加氮氣,基本上一定有助焊接潤濕的提昇。氮氣對潤濕的基本作用有二:
-
可以提昇錫膏中助焊劑保護錫粉的作用及清除氧化的效果。當錫膏的活性得到保障,潤濕自然好。
-
可以降低電路板焊墊在高溫環境下氧化的程度、提高焊墊的潤濕度。氮氣尤其對OSP表面處理板子在第二面過爐的效果最好,但是對保護ENIG焊墊氧化的幫助則不大。
但如果錫膏及電路板的焊墊在進入回焊爐前就已經變質或氧化,就算氮氣再厲害,應該還是無法做到起死回生地步的。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
另外,這裡有個可能讓你感到困擾或有興趣的現象:在添加氮氣的環境下零件引腳的爬錫高度將會低於空氣環境(未開氮氣)。怎麼會這樣?這是因為氮氣雖然有效地潤濕了電路板的焊墊,但可能也因為氮氣下焊錫在焊墊上的擴散效果太好,反而影響到零件引腳的爬錫高度。就類似「水往下流」的趨勢一樣,焊錫會越加地往容易吃錫的地方移動,既然焊墊變得容易潤濕吃錫了,何必再克服重力往引腳上面爬呢。
相關延伸閱讀:PCB及電子零件焊錫吃得好不好(潤濕、不潤濕、縮錫、退潤濕)的原理是什麼?
立碑現象/墓碑效應(Tombstone)
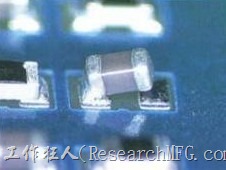 墓碑效應(Tombstone)是因為同一個零件兩端融錫時間不一致,最終造成兩端受力不均,以致一端受力較大為支點舉起零件另一端懸空而成。
墓碑效應(Tombstone)是因為同一個零件兩端融錫時間不一致,最終造成兩端受力不均,以致一端受力較大為支點舉起零件另一端懸空而成。
基於以上論點,墓碑效應通常會落在那些一端有著大面積佈銅,另一端只有小銅箔的零件上,因為佈銅面積大小不同直接影響了焊墊的受熱程度,讓融錫出現時間差,一旦先融錫端的力距超過了零件重心重量,立碑現象於焉而生。
另外,錫膏量印刷於兩端不一致、或是印刷偏移、或是置件偏移都可能造成墓碑效應。
在回焊爐中添加氮氣通常會使得焊墊的潤濕變快變好,但也可能加大融錫的時間差,使得立碑的零件變多且變得嚴重。可以嘗試關閉氮氣看看是立碑情形是否有改善。
相關延伸閱讀:電阻電容小零件發生空焊及立碑(墓碑效應)的原因
延伸閱讀:
SMT回焊爐加氮氣(N2)的優缺點探討
整理幾種常見PCB表面處理的優缺點
無鉛噴錫板(HASL)上錫不良原因(資料收集)
ENIG表面處理是什麼電路板?有何優缺點?
回焊後焊點處出現波紋狀的皺褶或龜裂現象是怎麼造成的?
ENIG表面處理PCB焊墊的兩大潛在問題(黑鎳與富磷層)及預防措施
為何SMT的錫膏在使用前要先攪拌退冰?還要管控開封後的使用期限?

錫膏是現代電子組裝製造中不可或缺的焊接材料,而且扮演一個非常重要的角色,它主要被應用於SMT(Surface Mount Technology,表面貼焊技術)中用來將電子零件焊接於PCB,讓不同電子零件的訊號可以連接在一起形成一個有效的迴路。哪你知道不論是早期的含鉛錫膏或是現在流行的無鉛錫膏及無鹵錫膏為何在使用前都必須要先經過攪拌?退冰回溫?而開封後的錫膏也必須管控其使用期限?
錫膏使用前為何要退冰回溫?


這是因為錫膏存放時需要低溫5~10°C冷藏,剛從冰箱中取出的錫膏,其溫度一般會較車間溫度來得低,如果未經回溫就開啟瓶蓋,就容易吸收到空氣中的水氣並凝結沾附在錫膏中,沾有水氣的錫膏在回焊(reflow)的過程中會因為受熱超過100°C而快速氣化變成水蒸氣並膨脹體積,造成爆錫現象,產生錫珠。
錫膏回溫一般要求從冰箱取出後不開蓋放置於室溫2-4小時使其溫度與室溫一致。
為何SMT的錫膏在使用前要先攪拌?
錫膏(solder paste)為錫粉合金(alloy powerder solder)以及助焊劑(flux)所組合而成的膏狀物,膏狀的錫膏易於透過鋼板(stencil)塗抹於PCB的焊墊,而且還可以在回焊(reflow)前起到黏住電子零件使其不因震動而偏移掉落,而助焊劑中又包含有多種不同的液體成份,如松香、活性劑、溶劑、增稠劑等,這種混合物在靜置一段時間後比重較高者會因為重力的關係而開始下沉出現沉積(deposition)分層的現象,使用前如果不將這些物質重新混合,一旦打開錫膏罐後就會明顯發現有一層溶劑漂浮在最上方,而較重的金屬錫粉則全部集中在了底層,膏狀分離變成水狀或硬塊,這樣的錫膏當然就失去了其原本各司其職的功用。
而攪拌錫膏的目的就是為了將錫膏中原本的成分重新充分混合,一般人工攪拌的方法為同一方向攪拌20~30圈大概1分種即可,過多的攪拌次數其實反而會破壞錫膏中原本圓形的錫球形狀而變成橢圓形,這樣反而不利後續的錫膏印刷(因為橢圓形錫粉會影響排列的數量),而且人工攪拌時間過久或次數過多也容易讓錫膏與空氣接觸,加速錫粉氧化的程度,不利後續的焊接作業。
現在則有新式的全自動錫膏攪拌機採用仿行星繞行恆星運轉原理(參考文章最上方圖說),將錫膏罐放置水平45°傾斜角,然後通過罐體同時自轉及公轉的離心力來進行攪拌,錫膏罐內的錫膏就會依據慣性以螺旋路徑來進行混合,這樣的攪拌方式經過驗證後已確認不需要事先將錫膏退冰及開瓶的情況下就可以進行攪拌,而且因為高速離心旋轉會使得錫膏內不同物質間流動產生的摩擦也會順帶使得錫膏溫度上升,大大的降低錫膏提前接觸空氣氧化、吸收水氣的機率並縮短了退冰的時間。
錫膏開封後為何要控制其暴露於產線的時間
 這是因為錫膏中含有助焊劑,而助焊劑中又含有乙醇類等易揮發的溶劑,也就是說錫膏一旦開封後溶劑就會開始揮發(其實不開蓋密封的情況下也會揮發,只是速度很慢,就類似汽水裝在寶特瓶中一段時間後也會沒氣是一樣的道理),尤其是那些已經塗抹在鋼板或是已印刷在PCB上的錫膏,其溶劑揮發的速度會更快,所以,一般有紀律的SMT廠都會嚴格管控錫膏暴露車間的使用標準及壽命。
這是因為錫膏中含有助焊劑,而助焊劑中又含有乙醇類等易揮發的溶劑,也就是說錫膏一旦開封後溶劑就會開始揮發(其實不開蓋密封的情況下也會揮發,只是速度很慢,就類似汽水裝在寶特瓶中一段時間後也會沒氣是一樣的道理),尤其是那些已經塗抹在鋼板或是已印刷在PCB上的錫膏,其溶劑揮發的速度會更快,所以,一般有紀律的SMT廠都會嚴格管控錫膏暴露車間的使用標準及壽命。
一般要求錫膏回溫2H,超過8H不得回收,超過12H或24H報廢。
延伸閱讀:
讓通孔元件/傳統插件也走迴焊爐製程(paste-in-hole)
如何挑選一支適合自己公司產品的錫膏 (Solder paste selection)
客戶評核SMT製程時最重要的程序及環節是什麼?錫膏管控注意事項
電路板焊接後為何要水洗?水洗製程、免洗製程有何差異?助焊劑的種類
低溫錫膏(LTS)製程有機會成為未來主流嗎?還是曇花一現?
 過去為了因應歐盟的「有害物質限用指令(Restriction of Hazardous Substances Directive 2002/95/EC, RoHS)要求,PCBA(電路板組裝)製程的焊錫從錫鉛(SnPb)轉變為錫銀銅(SAC)合金,卻相對的提高了焊錫的熔接溫度。為了因應節能減碳大趨勢,現在似乎有越來越多企業正在嘗試將SAC高溫製程往低溫製程(Low Temperature Soldering, LTS)方向發展的趨勢。
過去為了因應歐盟的「有害物質限用指令(Restriction of Hazardous Substances Directive 2002/95/EC, RoHS)要求,PCBA(電路板組裝)製程的焊錫從錫鉛(SnPb)轉變為錫銀銅(SAC)合金,卻相對的提高了焊錫的熔接溫度。為了因應節能減碳大趨勢,現在似乎有越來越多企業正在嘗試將SAC高溫製程往低溫製程(Low Temperature Soldering, LTS)方向發展的趨勢。
其實當初焊錫製程轉入SAC合金後,SMT生產線的回焊峰值溫度(peak temperature)也從原本的220˚C上升到了250˚C左右,而焊錫溫度的升高也意味著零件材料及生產成本的提高,比如說需要使用到更耐高溫的材料,最大的改變是工程塑膠材料變更,另外,高溫也惡化了生產的品質,比如說材料在高溫下更容易變形造成焊接不良。
而目前最為大家所熟知的低溫焊錫則是以錫(Sn)為基礎添加鉍(Bi)的錫鉍(SnBi)與錫鉍銀(SnBiAg)合金。所以,今天我們就來大致探討一下LTS的優缺點、可行性與未來可能趨勢。
LTS製程的優點:
-
節能減碳、降低能耗。因為採用較低熔點的焊錫合金,形成焊接所需要的溫度及時間就會跟著降低與減少,能耗相對地也就降低,達到節能減碳的目的。
-
降低高溫材料需求、降低材料成本。在室溫以上使用耐溫較低的材料,通常意味著較低的材料成本,至少材料的加工成本就比較低。
-
降低製程門檻、提高生產良率。將焊錫合金從SAC改為SnBi,其回焊爐內的最高溫會從250˚C降低到175˚C左右,相對地電路板在高溫下的變形率也會跟著降低約50%。板子變形與翹曲是BGA及LGA等大顆無引腳零件形成HIP/HoP虛焊的一大主因,也是造成MLCC破裂的重要兇手之一。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
LTS製程的缺點:
-
焊點的長期信賴性不佳。
低溫焊錫的最大缺點就是其焊點的機械強度不佳,也就是說焊點比較脆且容易因應力作用而產生錫裂現象。與SnPb及SAC合金焊錫比較起來,SnBi合金的焊錫強度就顯得非常不耐冷熱衝擊(thermal shock)與摔落撞擊(impact drop)。
-
回焊製程中容易產生Hot-tearing(熱裂縫、熱撕裂)缺點。
Hot-tearing缺點容易出現在SAC錫球與SnBi錫膏的混合焊接製程的PCB焊墊表面,其實Hot-tearing也容易出現在無鉛與錫鉛的混合(hybrid)製程中,尤其好發在BGA這類已經有預焊錫的零件焊點。這是因為在焊接的過程中,SAC錫球的熔點較高,不易熔化,就算熔化後在冷卻的過程中也會較早固化,而SnBi錫膏則一定會在回焊的過程中熔化,冷卻時也會比SAC更慢固化。想像一下在回焊爐的冷卻過程中,BGA錫球已經固化或根本就未熔化,只剩下一小部分呈現漿態的SnBi焊錫,這時PCB及BGA載板也從高溫的變形中漸漸回復,一旦高溫時BGA載板與PCB的間隙較小(變形)而回溫後間隙變大(變形回復),就會拉扯那些還未來得及完全固化的漿態SnBi焊錫,於是形成像是撕扯過的Hot-tearing裂縫。
SAC合金的BGA錫球與低溫錫膏(LTS)混用時該使用何種溫度曲線(temperature profile)?
其實使用低溫錫膏(LTS)時最好配合同時使用低溫錫球及低溫profile,這樣才能取得低溫錫膏的所有好處與最佳的焊接效果與品質。不過迫於現實的無奈,目前市面上幾乎拿不到低溫錫球的BGA,所以只好退而求其次,混用低溫錫膏(LTS)與SAC合金的BGA錫球。
如果想要取得SAC與低溫錫膏混用的最佳品質效果,就得想辦法降低Hot-tearing所造成的影響,而其最好的溫度profile則為沿用SAC的溫度profile,因為高溫profile可以同時熔化SAC與SnBi合金,讓SAC有機會擴散至SnBi合金區域,進而改變SnBi配方的合金比率,這樣就有機會可以稍稍拉升SnBi區域的固化溫度,另外建議要加速峰值溫度後的冷卻速率,尤其是加速217˚C(SAC305)到138°C(Sn42Bi58)之間的降溫速率,目的是在SAC焊錫區域固化後,讓SnBi焊錫區域可以在最短時間內也跟著馬上固化。不過這麼一來就失去了使用LTS的所有優點,而且焊錫強度還沒有SAC合金來得好,還不如直接使用SAC錫膏。所以,以上所言的根本就是一堆廢話嘛!XD
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
相信大部分會選用低溫錫膏的情況,都是因為零件無法承受SAC的高溫profile。在這種情況下只能選用低溫錫膏的低溫profile,個人建議在不影響焊接品質的情況下要盡量降低回焊的峰值溫度,其目的是為了降低PCB及BGA載板在回焊時的熱變形量,而同時還要加速回焊峰值溫度後的冷卻速率,目的當然也是為了在板子變形回復前就搶先固化低溫焊錫,不過如果過度加速冷卻速率可能有惡化BGA焊錫破裂的風險,建議應確實評估,做過信賴性測試比較後選出一個較佳的溫度冷卻速率才執行,至於如何評估LTS的焊錫性,台灣有幾家實驗室都有類似的服務,可以先諮詢這些實驗室。不建議調升回焊峰值溫度,因為溫度越高,PCB及BGA載板的變形量就會越大。
如何加強LTS的機械強度?加強焊錫強度?
 目前比較可行的LTS焊點補強方案為使用底部填充膠(underfill),這方案其實在CSP(Chip Scale Package)及flip-chip一開始出現的時候就有了,後來也應用到BGA上面,一般會使用環氧樹脂(epoxy)材質的膠水點在BGA或相似零件的邊緣,藉由毛細作用的原理讓膠水滲透並充滿零件的底部,然後加熱固化,達到填充縫隙、強化焊點的目的,後來也有人採用黏稠度比較高的膠水選擇性點在BGA的四個角落(coner bond)或BGA四邊緣(edge bond)來強化固定。
目前比較可行的LTS焊點補強方案為使用底部填充膠(underfill),這方案其實在CSP(Chip Scale Package)及flip-chip一開始出現的時候就有了,後來也應用到BGA上面,一般會使用環氧樹脂(epoxy)材質的膠水點在BGA或相似零件的邊緣,藉由毛細作用的原理讓膠水滲透並充滿零件的底部,然後加熱固化,達到填充縫隙、強化焊點的目的,後來也有人採用黏稠度比較高的膠水選擇性點在BGA的四個角落(coner bond)或BGA四邊緣(edge bond)來強化固定。
後來也有所謂的underfilm(底部填充片)出現,在板子印刷錫膏後透過SMT貼片機來將其擺放在PCB的BGA位置(避開焊點),然後上面才放置BGA,最後與BGA一起通過回焊爐高溫來融化膠片填充空隙,冷卻後凝固。不過要注意的是,underfill都是在板子組裝完成且功能測試無誤後才會作業,而underfilm則是在SMT製程中就添加,產品的良率如果不高的話,重工將會非常麻煩。
另外,隨著LTS應用的增加,現在也有所謂的【Epoxy paste】及【Epoxy flux】製成應運而生。【Epoxy paste】是在錫膏中添加epoxy,直接印刷錫膏過回焊加熱就可以了,但既然是添加在錫膏中,其用量就不可能多,對BGA零件的焊錫強度加強可能有限,但如果僅針對片式零件(chip component)或是LED燈板來說應該還是會有些效果的。【Epoxy flux】則採用錫膏印刷後點膠作業再貼片,有點類似underfilm。以上兩種添加Epoxy的製程效果其實都有待進一進驗證,而且都是在測試前就已完成作業,對良率不高的產品使用前建議斟酌使用。
就工作熊自身的應用經驗,添加underfill確實可以起到加強BGA抗應力的能力,但只能延緩焊錫因為應力作用所噵致破裂的問題,而無法完全根治,也就是說使用一段時間後,該出問題的焊點還是會出問題。所以,解鈴還須繫鈴人,要想辦法盡量降低影響焊點的應力來源。
(對於大陸那些盜文網站,複製貼上本站文章後,居然還改成自己公司的名字,感到無恥!文章內容部份防止複製編排可能造成您閱讀的不便,請見諒!)
那些產品有機會可以採用LTS製程?
既然我們已經了解到LTS製程產品的焊點比較脆、不耐應力,所以只要電子產品的使用環境不是處在劇烈的熱應力(高低溫循環)變化或機械應力(摔落撞擊)作用,以及產品無長期壽命設計保證需求下,應該都可以考慮導入LTS(低溫錫膏)製程,畢竟LTS既可以節能又可以省成本。以下是一些業界引用LTS的準則參考:
-
產品安裝後固定不動者。不建議手持裝置使用。手持裝置容易因為隨身攜帶操作而掉落造成機械衝擊應力。
-
產品設計使用壽命最好在5年以內或更短。建議要執行MTBF(Mean Time Between Failures)評估。
-
主要零件如果有額外應用焊點補強保護機制為佳,如點膠或塡膠。
-
IO零件如果有額外防插拔應力作用的機構設計為佳,如防過插、防搖晃等機構設計。
-
產品使用環境最好低於40˚C,最大運作溫度盡量不超過85˚C。
-
在一般的室內(indoor)環境中使用,無劇烈高低溫波動。不建議車用或戶外(outdoor)環境中使用。
目前看到LTS比較多運用在LED燈上面,mini-LED也有少部分採用,部分PC的產業也在評估中。
低溫製程的未來發展趨勢?
以節能減碳的角度來看LTS錫膏製程確實比較節省能源,也能降低零件對高溫塑膠材料的要求省成本,但目前的LTS錫膏有個致命的缺點,就是普遍的信賴性不佳,焊點比較脆,或許對一些細小零件不會造成太大影響,但對一些有應力承受需求的零件,比如I/O零件,或是產品受外力作用後可能彎曲電路板的產品,或是經常處於震動或是熱應力作用下的產品,就不太適合LTS製程,只能說LTS錫膏雖然能符合節能減碳訴求,但依然還有很長的路要走,也或許LTS最終無法完全取代SAC,比較可能是LTS與SAC並行。
延伸閱讀:
如何挑選錫膏 (Solder paste selection)
低溫錫膏製作HotBar焊接的可行性評估
介紹認識【錫膏(solder paste)】的基本知識
焊接採用無鉛低溫錫膏SnBi, SnBiAg的目的?
到底是濕度還是溫度對SMT生產品質影響比較大?生產車間環境濕度及溫度對SMT品質是否有影響?

有網友提問關於車間環境濕度對SMT品質是否會有影響?原因是「SMT生產線把錫膏印刷不下錫的問題,歸咎為是天氣乾燥的原因」。 這位網友認為「濕度的管控更多的原因是為了減少對濕敏零件(Moisture Sensitive Devices)和靜電(ESD)影響,對於錫膏印刷機不下錫,跟濕度影響應該不大,倒是溫度對錫膏印刷的品質影響比較大」。真的是這樣嗎?
這個問題其實牽涉到幾個面向。
 首先,我們得先了解錫膏的是由助焊劑(flux)與錫粉(solder powders)各占一半的體積比所組成的混合物,而助焊劑中又包含有松香、活性劑、增稠劑與溶劑,其中的溶劑為乙醇類揮發性液體,其起到融合錫膏中各成分的作用。一旦,錫膏開罐後,其內部的乙醇類溶劑就會開始揮發(其實不開蓋密封的情況下也會揮發,只是速度很慢,就類似汽水裝在寶特瓶中一段時間後也會沒氣是一樣的道理),在乾燥及高溫的環境下更會加速乙醇類溶劑的揮發,造成錫膏乾涸。
首先,我們得先了解錫膏的是由助焊劑(flux)與錫粉(solder powders)各占一半的體積比所組成的混合物,而助焊劑中又包含有松香、活性劑、增稠劑與溶劑,其中的溶劑為乙醇類揮發性液體,其起到融合錫膏中各成分的作用。一旦,錫膏開罐後,其內部的乙醇類溶劑就會開始揮發(其實不開蓋密封的情況下也會揮發,只是速度很慢,就類似汽水裝在寶特瓶中一段時間後也會沒氣是一樣的道理),在乾燥及高溫的環境下更會加速乙醇類溶劑的揮發,造成錫膏乾涸。
我們可以把錫膏想像成黏土,黏土則是一種富含水分的泥土,當黏土乾燥後就會變硬、不具可塑性,而錫膏也是依樣,當其中的溶劑開始揮發,錫膏的黏度就會增加且變黏稠,會使得錫膏難以順利地印刷在電路板子上,也會因為黏在鋼板開孔的垂直面上而影響落錫量,甚至堵塞造成漏印,已經印刷在電路板上的錫膏則可能發生坍塌(因為溶劑揮發後部分體積縮小無法支撐原來的形狀),造成短路或是錫珠,乾涸的錫膏表面也較難黏住零件,在電路板移動的過程中容易被甩飛移位。
所以,基本上我們可以先歸結較乾燥的車間環境,較容易使得錫膏變乾而影響錫膏印刷的品質。
其次,我們應該探討的是SMT的生產車間有無溫溼度管控?SMT生產絕不能靠天氣吃飯,就如同前面說過的天氣太乾燥會加速錫膏中溶劑的揮發,但是環境如果太潮濕,則容易讓水氣附著於錫膏上,沾有水氣的錫膏在回焊(reflow)的過程中會因為受熱超過100°C而快速氣化變成水蒸氣並膨脹體積,造成爆錫現象,產生錫珠。因次工作熊強烈建議,SMT產線一定要有濕度管控,而一般我們會要求管控SMT產線的濕度在35~65%RH之間,或40%~70%RH之間,沒有很一致的標準,而IPC-J-STD-020文件定義的暴露車間濕度為60%RH。
個人建議濕度要穩定地維持在一定範圍內,這樣比較能維持生產品質的一致姓,濕度不只會影響錫膏的品質,當濕度越低時,也越容易引起靜電反應,擊穿電子零件或吸附零件,當濕度越高時,材料則越容易受潮或黏住零件,人體對過高及過低的濕度也會感覺不適。
 其三,錫膏開罐後暴露於生產車間的時間又是如何管控的?我們前面已經說過,錫膏開罐後,錫膏中的溶劑就會開始揮發,所以我們不只要管控錫膏直接暴露於大氣環境下的溼度,更要管控暴露的時間,因為暴露時間越長,溶劑的揮發就越多,出問題的機率也就越高。一般我們會要求錫膏開蓋超過8H不得回收,超過12H或24H報廢,不建議自己添加溶劑,因為你不知道溶劑揮發了多少,更不知道需要添加多少溶劑,添加了溶劑後還得重新充分攪拌均勻。而對於已經塗抹於鋼板上的錫膏,其溶劑揮發的速度會比在罐子裡的更快,一般建議要在3H內用完。
其三,錫膏開罐後暴露於生產車間的時間又是如何管控的?我們前面已經說過,錫膏開罐後,錫膏中的溶劑就會開始揮發,所以我們不只要管控錫膏直接暴露於大氣環境下的溼度,更要管控暴露的時間,因為暴露時間越長,溶劑的揮發就越多,出問題的機率也就越高。一般我們會要求錫膏開蓋超過8H不得回收,超過12H或24H報廢,不建議自己添加溶劑,因為你不知道溶劑揮發了多少,更不知道需要添加多少溶劑,添加了溶劑後還得重新充分攪拌均勻。而對於已經塗抹於鋼板上的錫膏,其溶劑揮發的速度會比在罐子裡的更快,一般建議要在3H內用完。
至於車間溫度對SMT品質的影響,溫度越高,溶劑揮發會越快,但是一般我們不太可能讓車間溫度長期超過30°C以上?因為沒有多少人願意在高溫的環境下穿著工作服持續工作。所以,相對來說溫度對SMT的影響就沒有濕度來得大。
延伸閱讀:
讓通孔元件/傳統插件也走迴焊爐製程(paste-in-hole)
如何挑選一支適合自己公司產品的錫膏 (Solder paste selection)
客戶評核SMT製程時最重要的程序及環節是什麼?錫膏管控注意事項
電路板焊接後為何要水洗?水洗製程、免洗製程有何差異?助焊劑的種類
網友求助問:SMT焊點表面出現一層顆粒狀金屬球是什麼?
這個案例是一位苦主在國外論壇上貼出來的幾張關於SMT焊接後的照片,苦主說明他們家生產了一批PCBA板子,但是在 […]
The post 網友求助問:SMT焊點表面出現一層顆粒狀金屬球是什麼? first appeared on 電子製造,工作狂人(ResearchMFG).這種片式電容偶發焊錫短路不良現象是怎麼形成的呢?
這個"片式電容(chip capacitor)偶發焊錫短路不良現象",是工作熊在國外論壇上 […]
The post 這種片式電容偶發焊錫短路不良現象是怎麼形成的呢? first appeared on 電子製造,工作狂人(ResearchMFG).用PWI(製程窗口指數)量化並快速確認回焊溫度是否合格
印象中這個回焊溫度曲線的PWI(Process Window Index,製程窗口指數)好像是由KIC所提出來 […]
The post 用PWI(製程窗口指數)量化並快速確認回焊溫度是否合格 first appeared on 電子製造,工作狂人(ResearchMFG).[简中]什么是TAL(液相以上时间)及其在PCB组装中的重要性
TAL (Time Above Liquidus) 在电子组装业中通常指在回焊(Reflow)制程中,焊接材料 […]
The post [简中]什么是TAL(液相以上时间)及其在PCB组装中的重要性 first appeared on 電子製造,工作狂人(ResearchMFG).



